 | |
МЕНЮ
- Главная
- Языкознание филология
- Финансовые науки
- Управленческие науки
- Товароведение
- Технология
- Теплотехника
- Теория организации
- Теория государства и права
- Таможенная система
- Схемотехника
- Строительство
- Страхование
- Статистика
- Религия и мифология
- Психология и педагогика
- Промышленность производство
- Медицинские науки
- Медицина
- Краеведение и этнография
- Компьютерные науки
- История
- Искусство и культура
- Информатика
- Инвестиции
- Издательское дело и полиграфия
- Зоология
- Журналистика
- Естествознание
- Деньги и кредит
- Делопроизводство
- Гражданское право и процесс
- Государство и право
- Геополитика
- Геология
- Геодезия
- География
- Военная кафедра
- Ветеринария
- Валютные отношения
- Бухгалтерский учет и аудит
- Ботаника и сельское хоз-во
- Биржевое дело
- Биология и химия
- Биология
- Безопасность жизнедеятельности
- Банковское дело
- Астрономия
- Астрология
- Архитектура
- Арбитражный процесс
- Административное право
- Авиация и космонавтика
- Карта сайта
Курсовая работа: Вакуумная плазменная технология высоких энергий
Курсовая работа: Вакуумная плазменная технология высоких энергий
Вакуумная плазменная технология высоких энергий
Содержание
Введение
1. Вакуумная плазменная технология высоких энергий
2. Time and spatially resolved studies of an kHz-excited atmospheric pressure plasma jet for industrial applications
2.1 Основные положения
2.2 Общие наблюдения
2.2 .1 Динамический реактивный поток
2.2.2 Процессы распространения в реактивной зоне
2.3 ICCD наблюдения
2.4 Электрические исследования
2.5 Реактивный поток в атмосфере гелия
2.6 APPJ для смещения
Заключение
Список использованных источников
Введение
В настоящее время вакуумная плазменная технология высоких энергий (ВПТВЭ) модифицирования поверхности изделий и получения специальных покрытий из высокоионизированных потоков "металлической" плазмы в атмосфере реакционных газов нашла достаточно широкое применение во всех экономически развитых странах мира благодаря пионерским работам ученых СССР, выполненных в середине 70-х годов в области создания электродуговых генераторов и ускорителей таких потоков [1].
Работа этих устройств основана на использовании так называемой "вакуумной" дуги катодной формы, горящей в продуктах эрозии интегрально холодного катода и формирующей плазменные потоки, состоящие из атомов, ионов и микрокапель материала катода [2]. При этом принципиально новым было то, что в компактном низковольтном вакуумном устройстве удалось получить интенсивные плазменные потоки металла с расходом массы dm/dt=/iJ ((/х=0,4 ... 1,5)-10"7 кг/К - коэффициент электроэрозии катода, J -ток дуги), содержащие (30 ... 80)% ионов различной кратности ионизации со средней кинетической энергией (30 ... 150) эВ. Поэтому технические характеристики первых же образцов электродуговых ускорителей, получивших название "Пуск" по первым буквам словосочетания "плазменный ускоритель" (разработчик МВТУ им. Баумана), и электродуговых генераторов, получивших название "Булат" (разработчик Харьковский физико-технический институт), были принципиально не достижимы на разрабатываемых в тот период на западе устройствах, работающих на газовых разрядах.
Разработка плазменных генераторов и плазменных ускорителей для технологии обработки поверхности изделий машиностроения базировалось на использовании результатов, полученных при создании электрореактивных ускорителей двигателей космических аппаратов, электродуговых аппаратов разделения изотопов и получения особо чистых материалов для атомной промышленности, электродуговых гетерных вакуумных насосов и вакуумных электродуговых переключателей электрических токов большой величины [1-3].
Достигнутые к концу 70-х годов технические показатели оборудования для вакуумной плазменной технологии высоких энергий, а также высокая адгезионная прочность покрытий и открытый эффект получения покрытия из нитрида титана при температурах существенно более низких (300 ... 400 °С), чем температуры, вытекающие из законов равновесной химической термодинамики (800 ... 1000 °С) и предопределили интенсивное развитие этой технологии.
1. Вакуумная плазменная технология высоких энергий
Известная установка для вакуумного ионно-плазменного нанесения покрытий, собранная на базе вакуумного поста установки распыления материалов (УРМ 3.279.029) с электродуговым принципом генерации плазмы металлов в вакуумной дуге катодной формы и холловским ускорением плазменных потоков (так называемый холловский торцевой ускоритель металлической плазмы) была модернизирована. И на основании этой модернизации был создан торцевой холловский ускоритель с названием "Пуск-КуАИ" (рисунок 1.1) По сравнению с известными схемами торцевого холловского ускорителя изменено геометрическое взаимоположение торцевой поверхности катода, соленоида и анода ускорителя. Профиль внутренней поверхности выходного сечения анода (сопла) максимально приближен к профилю эквипотенциальной поверхности силовых линий магнитного поля в этом месте при величине индукции магнитного поля (3,0 ... 4,5) мТл на оси соленоида около катода. Изменены геометрические параметры катода и условия его охлаждения в соответствии с расчетами по минимизации микрокапельной фазы. Введен дополнительный анод, создающий эффект электростатической линзы для ионного потока, что позволило реализовать три различных режима работы ускорителя. С целью снижения температуры нитридообразования и повышения стабильности горения вакуумной дуги на малых токах подача реакционного газа осуществлена через зону генерации и ускорения металлической плазмы. Выходное сечение ускорителя укомплектовано жалюзями и кольцевой заслонкой для улавливания микрокапельной фазы. Для повышения эффективности и скорости ионного травления регулируемое напряжение смещения доведено до 2,5 кВ и существенно улучшена система защиты высоковольтного выпрямителя от возникновения или развития микродуговых привязок на детали. Созданный ускоритель обеспечивает уменьшение микрокапельной фазы, по сравнению с известными схемами более чем 2-4 раза и на (20 - 30 %) увеличивает степень ионизации плазменного потока.

Рисунок 1.1 - Схема плазменного ускорителя "Пуск-КуАИ": 1 - катод; 2 - анод; 3 - соленоид; 4 - фланец крепления генератора к вакуумной камере; 5 -электрод поджига дуги; б - система защиты от сброса дуги на боковую поверхность катода; 7 - канал подачи реакционных газов; 8 - дополнительный анод; 9 - съемный кольцевой экран. Пунктиром проведены силовые линии электрического и магнитного поля
В работах[4-6] приведены результаты теоретических и экспериментальных исследований и выбраны диапазоны технологических режимов, при которых образования соединений происходит на поверхности конденсации в условиях эффективной динамической очистки поверхности роста покрытия; приведен механизм образования нитридов переходных металлов в результате диссоциативной хемосорбции азота путем образования ковалентных связей с металлом по схеме
N N
N2(газ) → N2(адс.) →І + І
Ме Ме
И приведены энергетические условия протекания такой реакции, обеспечивающие достаточные условия образования соединения стехиометрического состава; приведены условия обеспечения высокой адгезионной прочности покрытия; приведены аналитическое соотношение связывающие параметр шероховатости Ra с толщиной наращиваемого покрытия в рамках теории флуктуации термодинамических величин в адсорбционном слое.
В работе [7] приведены результаты исследования свойств покрытий из титана, циркония, хрома, алюминия, молибдена и их нитридов и карбидов, а также покрытий из никеля и алмазоподобного углерода, исследованы их микроструктура, триботехнические характеристики, микротвердость, модули упругости, адгезионная и когезионная прочность покрытий, а также остаточные напряжения в них. Предложена гипотеза о механизмах самопроизвольного разрушения покрытий как на стадии роста, так и последующего остывания системы покрытие-основа, которая была доказана экспериментально и созданной математической моделью расчета остаточных и временных напряжений, возникающих при наращивании покрытий [8,9]. В работе [10] приведены математические модели расчета температур в телах с изменяемой геометрией применительно к наращиванию покрытий и аналитические методы решения таких краевых задач для двухслойных систем с подвижными границами. На основании результатов испытаний на схватывание материалов в вакууме выдвинута и на рассмотренном классе соединений подтверждена гипотеза о том, что соединения, имеющие конденсатный характер диссоциации в твердой фазе и, следовательно, обогащающие поверхность трения металлической компонентой, обладают большими коэффициентами адгезионного схватывания по сравнению с соединениями, имеющими газообразный характер диссоциации. Показано, что недефицитными и недорогими соединениями с газообразным характером диссоциации и перспективными для износостойких покрытий в вакууме являются нитриды и карбонитриды титана и циркония. В то время как моно- и двойные окислы, нитриды, карбиды, оксинитриды и карбонитриды других металлов имеют конденсатный характер диссоциации, либо дороги и дефицитны, либо нетехнологичны для получения износостойких покрытий. Установлено, что коэффициент адгезионного схватывания в выбранных перспективных покрытиях возрастает при их нестехиометрическом составе и наличии в них микрокапельной фазы металла, а износостойкость зависит от микрогеометрии поверхности основы, режимов ионного травления и остаточных напряжений в них. Показано, что во многом этими же причинами определяется износостойкость этих систем при их трении и в условиях ограниченной смазки (режущий инструмент, высоконагруженные пары трения).
В работах установлено, что оптимальные покрытия из нитридов и карбонитридов титана и циркония обладают высокой износостойкостью (первый-второй класс износостойкости) при сухом трении в вакууме, высокой стойкостью к общей и контактной коррозии и стабильным значением коэффициента трения, который технологическим путем может быть изменен от 0,08...0,12 (антифрикционные системы) до 0,18...0,26 (фрикционные системы). При использовании таких покрытий в парах трения с твердыми смазочными покрытиями слоистой структуры (типа дисульфида молибдена) и твердыми смазочными покрытиями со связующими (типа смазок ВНИИ НП) коэффициент трения уменьшается до 0,04...0,06 при незначительном изменении интенсивности изнашивания. Исследование влияния покрытий на статическую и длительную прочность материала основы показало, что основными факторами, влияющими на эти параметры, являются температура конденсации и время ионного травления поверхности, при выборе которых меньше характерных для данного материала основы значений, предел текучести, прочность на растяжение и предел выносливости материала основы с покрытием не уменьшаются и лежат в пределах допусков на эти материалы. В то же время, величина дисперсии этих показателей уменьшается до 3,5 раз по сравнению с образцами без покрытий, что существенно повышает вероятность безотказной работы узлов трения с такими покрытиями [2].
Для нанесения покрытий на внутреннюю поверхность малоразмерной цилиндрической полости необходимо применять цилиндрический магнетрон, обладающий широкими функциональными возможностями (рисунок 1.2).
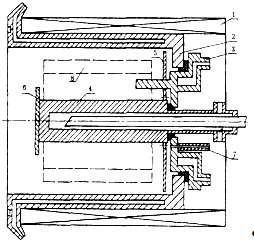
Рисунок 1.2 - Схема магнетронной цилиндрической системы. 1- соленоид, 2 - водоохлаждаемый корпус камеры, 3 — анод, 4 — катод, 5 - защитный экран, б — отражатель электронов разряда, 7 — канал подачи газа
Цилиндрический магнетрон (рисунок 1.2) с диапазоном регулирования напряжения анод-катод +1,5кВ и током разряда до 20А и возможностью работы в режиме прямого и обращенного магнетрона может быть использован не только для нанесения покрытий, но и как широкоапертурный источник высокоинтенсивного потока газовой плазмы при работе в режиме аномального тлеющего разряда для процессов газового ионного травления поверхностей и интенсификации процессов получения покрытий сложного состава при работе совместно с плазменным ускорителем.
В работах [2,12] приведен проект нового электродугового ускорителя совмещенной металлической и газовой плазмы с магнитоэлектростатической ловушкой для электронов плазменного потока. Физическая суть такого ускорителя определяется следующими обстоятельствами. Замагниченные электроны плазменного потока проводят его доионизацию и сепарацию микрокапельной фазы. Однако в существующих генераторах возможности по увеличению плотности замагниченных электродов около катода ограничены допустимым увеличением индукции магнитного поля, приводящим при значениях В > 4,5 мТл к перегреву центральной области катода и росту микрокапельной фазы из-за локализации катодного пятна вакуумной дуги в этой области. Однако, увеличить плотность этих замагниченных электронов можно за счет создания специальной магни-тоэлектростатической ловушки электронов, которая реализована следующим образом (рисунок 1.3). Внутренняя поверхность охлаждаемого анода выполнена таким образом, чтобы копировать поверхность силовых линий магнитного поля, у которого величина индукции магнитного поля на оси около катода составлял 3 - 3,5 мТл, а на оси около критического сечения сопла анода составляла 10-14 мТл. При таком магнитном поле ионы плазменного потока являются по-прежнему не замагниченными, а замагниченные электроны начинают совершать осциллирующие движения отражаясь от сечения с максимальной величиной магнитного поля (вероятность отражения в этих условиях достигает 0,5) и от отрицательного катода. Уход же электронов на анод ограничен параллельностью поверхности анода силовым линиям магнитного поля.
В этих условиях повышение плотности электронов в зоне магнитной ловушки стало таким, что при подаче через нее реакционного газа происходило зажигание интенсивного несамостоятельного разряда в этой области, горящего в смеси газа и металлической плазмы. Это в свою очередь приводило к дальнейшему росту плотности электронов. В результате через критическое сечение анода истекал смешанный поток газовой и металлической плазмы, который дополнительно ускорялся в зоне холловского ускорения (расходящаяся часть сопла анода). В таком ускорителе было получено уменьшение микрокапельной фазы более, чем в 20 раз даже по сравнению с ускорителем "Пуск-КуАИ" при существенном росте степени ионизации потока и кинетической энергии ионов.

Рисунок 1.3 - Схема плазменного генератора с магнитной ловушкой электронов "Пуск-Мэл": 1 - катод; 2 - профилированный анод; 3.1 и 3.2 - соленоиды; 4 - фланец крепления генератора к вакуумной камере; 5 - электрод поджига дуги; 7 - канал подачи реакционных газов. Пунктиром проведены силовые линии электрического и магнитного поля.
2. Time and spatially resolved studies of an kHz-excited atmospheric pressure plasma jet for industrial applications
2.1 Основные положения
APPJ - реактивный поток плазмы атмосферного давления;
ICCD - усиленная зарядка (нагрузка) соединительных устройств;
APGD - разгрузка жара (температуры) при атмосферном давлении.
На протяжении последних
лет холодная (нетепловая) плазма атмосферного давления получила значительный
импульс в продвинутой обработке материалов. Корона и рассеивание
диэлектрического барьера - вот признаки производящей схемы «самой старой»
плазмы; а вообще при помощи молекулярных газов производят волокнистую
неравновесную плазму. Типичные параметры разгрузки – температуры газов от
нескольких десятков до 100![]() . Плотность заряженных слоев
типична для неравновесной плазмы низкого давления.
. Плотность заряженных слоев
типична для неравновесной плазмы низкого давления.
Недавно же был предложен реактивный поток плазмы атмосферного давления (APPJ), что позволяет в местном масштабе отделять область производства плазмы от основания (подложки), которое и будет рассмотрено.
Это необходимо как условие для продвинутых процессов плазмы атмосферного давления, особенно при тонком смещении пленки. В настоящее время все еще нет никакого достаточного знания о динамике формирования плазменного потока, так же как и показательного (окна) процесса для более удобного способа разгрузки (выпуска) жара (температуры).
Пространственно-временные исследования частотно возбуждаемого APPJ показали, что поток – явление не постоянное. Вместо потока формировались так сказать плазменные «пули», зависящие от времени и изменяющие, часто по синусоидальному закону, напряжение возбуждения плазмы. В ходе измерения было установлено, что скорость этих пуль составляет порядка нескольких десятков км/сек, в то время как скорость газового потока выше лишь нескольких м/сек. Кроме того направление испускания «пуль» в цилиндрическом потоке может быть изменено при полном изменении напряжения возбуждения плазмы. В отношении этого было сделано интересное наблюдение, что направление испускания потока может быть задано встречным газовым потоком. В итоге получается, что поток формируется главным образом под действием электрического поля, а не тока.
Описанные выше наблюдения проводились над чистым гелием. В то время как основная область потока представляет собой высоко возбужденные разновидности гелия, во внешнем окутывающем слое они смешиваются с окружающей атмосферой. Проведенные во времени и пространстве исследования над оптической эмиссией могут так же успешно использоваться, что приведет к лучшему пониманию процесса взаимодействия потока благородного газа с молекулярным газом, необходимым для технических процессов.
В этом документе результаты, полученные в ходе экспериментов с атомными (He, Ar) и молекулярными (N2, …) газами будут представлены и критически обсуждены с акцентом на 2D (двумерное) и 3D (трехмерное) промышленные применения.
Текущая тенденция в промышленной разработке плазмы – развитие плазмы атмосферного давления как источника замены обработки плазмой в вакуумных системах. Эта замена желательна при сложной обработке плазмой 3D-образцов, чтобы развить источники плазмы, работающие на расстоянии. Это означает, что там существует расстояние между зоной производства плазмы и зоной обработки. Многочисленные потоки плазмы атмосферного давления (APPJ) известны в течении нескольких лет, главным образом включенных запасами (поставками) RF и работающий с газовыми потоками высокого типа (нормы), чтобы вынести плазму из зоны ее производства [11].
APPJ, представленный здесь, отнесен к упомянутым реактивным источникам. Тип газа, а следовательно и его скорость, низки, что характерно в диапазоне скоростей от 3 до 20 м/с, потоки включены с высоким напряжением (от 1 до 5 кВ) и низкой частотой (от 5 до 50 КГц).
2.2 Общие наблюдения
Самый простой вид этого APPJ источника состоит из диэлектрической трубы с двумя трубчатыми металлическими электродами и некоторого благородного газа (He, Ar), протекающего через нее. Для демонстрации того, что реактивный поток является главным образом электрическим явлением, а не единым потоком, он был отснят при помощи обычной цифровой (CCD) камеры со временем задержки в 1 секунду. (Смотрите рисунок 2.1). Для получения лучшего контраста при печати фотографии были конвертированы в черно-белые. В обоих случаях все параметры являлись схожими, кроме подключения электропитания к сети, как показано на рисунках. (Трубка изготовлена из кварцевого стекла с внутренним диаметром 4 мм, окруженная двумя алюминиевыми электродами длиной 5 см. Эти параметры неизменны для всех фотографий, представленных здесь. Используемое напряжение является синусоидальным с максимальным значением 7 кВ при частоте 13 кГц. Реактивный поток потребляет электрическую мощность примерно в 4 Вт.) Если передний электрод активен, а задний заземлен, как показано на рисунке 2.1(а), то труба развивает внешний поток. Однако если источник подключен к питанию наоборот (передний электрод заземлен), то внутренний реактивный поток формируется против газового потока (рисунок 2.1(б)). Это дает яркий признак того, что реактивный поток использует потенциальное различие для окружающей среды.
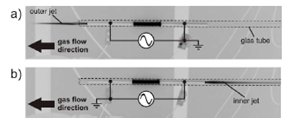
Рисунок 2.1 - реактивный поток по направлению (а) и против направления (б) распространения газового потока
Другой интересный факт состоит в зависимости длины реактивного потока от типа газа в потоке. Кто-либо мог бы интуитивно предположить, что реактивный поток станет более длинным и продолжительным с увеличением скорости газа. Но это верно только до максимальных значений. На рисунке 2.2 эта зависимость была взята для простой геометрии потока, описанной выше. Эта зависимость бралась при частоте 13 кГц, и понятие «длина потока» описывает длину лишь видимого диапазона света (фотографии CCD камеры, представленные на рисунке 2.4, были отсняты для каждого типа потока, после чего производилось их сравнение).
Рисунок 2.2 - зависимость реактивной длины от типа газового потока
На данной диаграмме обе кривые растянуты. Черная кривая, отмеченная квадратными символами, описывает зависимость газового потока, а серая показывает оптимальное пиковое значение поданного напряжения, где в соответствии с типом потока была соблюдена максимальная длина реактивного потока.
Длина реактивного потока имеет максимум по типу потока в точке 13 1/min. Вне этой точки реактивный поток становится все меньше и меньше, независимо от значения напряжения. Еще одно важное наблюдение заключается в том, что значение подводимого напряжения для достижения максимальной длины реактивного потока становится меньшим по отношению к растущему типу газового потока.
Какова же причина для этой зависимости от типа потока? В литературе важную роль в метастабильном состоянии играют атомы и молекулы, необходимые для того, чтобы выдержать APP при данном «способе накала (жара)», что описывает графа [11]. Плазма, о которой мы говорим, и есть плазма при данном способе накала. Это может быть замечено из текущей характеристики напряжения, показанной на рисунке 2.3, взятой из мультиреактивного источника, который будет описан позже. Принцип его работы тот же, но он содержит в себе множество отдельных реактивных источников, работающих параллельно так, что пиковое значение потока iпик не совпадает с номерами реактивных потоков.
Страницы: 1, 2
ИНТЕРЕСНОЕ
© 2009 Все права защищены. |