 | |
МЕНЮ
- Главная
- Языкознание филология
- Финансовые науки
- Управленческие науки
- Товароведение
- Технология
- Теплотехника
- Теория организации
- Теория государства и права
- Таможенная система
- Схемотехника
- Строительство
- Страхование
- Статистика
- Религия и мифология
- Психология и педагогика
- Промышленность производство
- Медицинские науки
- Медицина
- Краеведение и этнография
- Компьютерные науки
- История
- Искусство и культура
- Информатика
- Инвестиции
- Издательское дело и полиграфия
- Зоология
- Журналистика
- Естествознание
- Деньги и кредит
- Делопроизводство
- Гражданское право и процесс
- Государство и право
- Геополитика
- Геология
- Геодезия
- География
- Военная кафедра
- Ветеринария
- Валютные отношения
- Бухгалтерский учет и аудит
- Ботаника и сельское хоз-во
- Биржевое дело
- Биология и химия
- Биология
- Безопасность жизнедеятельности
- Банковское дело
- Астрономия
- Астрология
- Архитектура
- Арбитражный процесс
- Административное право
- Авиация и космонавтика
- Карта сайта
Курсовая работа: Химико-технологические системы производств кремния высокой чистоты
Курсовая работа: Химико-технологические системы производств кремния высокой чистоты
Введение
По распространенности в земной коре (27,6%) кремний занимает второе место после кислорода. Металлический кремний и его соединения (в виде силикатов, алюмосиликатов и др.) нашли применение в различных областях техники. В частности металлический кремний широко применяется в виде легирующих добавок в производствах различных марок сталей и цветных металлов.
Кремний является одним из основных полупроводниковых материалов электронной техники. Наиболее важными областями его применения являются: а - микроэлектроника: процессоры и навигационные системы, Интернет и цифровое телевидение, мобильные телефоны и т.п.; б - электротехника: вентили, управляемые тиристоры, мощные транзисторы, солнечная энергетика; в - ИК - техника: детекторы ионизирующих излучений.
Рынок полупроводниковых приборов определяет требования к качеству и параметрам материала. Увеличение степени интеграции, уменьшение размера чипа и, как следствие, увеличение кремниевых слитков и пластин вызвало и поддерживает в настоящее время дефицит поликристаллического кремния.
Для кремниевых технологий известна так называемая "бизнес-пирамида": полная выручка от продажи электронных систем на основе кремния на два порядка больше стоимости пластин.
Эффективность использования поликристаллического кремния в первичных поколениях пластин диаметром 100-150 мм составляла 30% (т.е. на каждые 100 г. поликристаллического кремния приходится только 30 г., реализованных в конечной пластине). Для пластин диаметром 200 мм этот параметр снижается до 17%, а экстраполяция на пластины диаметром 300мм предполагает величину в 5-10%. Этот пример показывает образование дефицита поликристаллического кремния при увеличении диаметра слитка.
В настоящее время только четыре страны мира обладают многотоннажной технологией получения поликристаллического кремния: США, Япония, Германия и Россия.
В таблице 1 показан один из вариантов прогнозов по производству кремния, которые являются компиляцией данных, опубликованных в журналах "Semiconductor International" и "Channel".
Таблица 1. Прогноз развития производства поликристаллического кремния (метрические тонны)
| Страна | 1996 | 1997 | 1998 | 1999 | 2000 | 2001 | 2002 | 2003 |
| США | 5500 | 6500 | 10750 | 14250 | 15750 | 15750 | 15750 | 16250 |
| Япония | 4000 | 5000 | 5500 | 6000 | 6000 | 6000 | 6000 | 6000 |
| Германия | 2750 | 2750 | 3500 | 5000 | 5000 | 5000 | 5000 | 6000 |
Начиная с 1996 года ощущается дефицит поликристаллического кремния. По прогнозам роста рынка видно, что в будущем не только нужды электроники будут определять рыночный спрос на поликристаллический кремний, но и спрос, сформированный солнечной энергетикой.
В XXI веке доля "солнечного" вклада в добываемую энергию стремительно возрастет, прежде всего из-за ограниченно количества природных источников энергии (нефть и газ), а также из-за экологических проблем(захоронения отходов атомной энергетики, парниковый эффект).
Электроника будет нуждаться в более, чем 25 тысячах тонн поликристаллического кремния в год к 2000 году без учета требований России, стран СНГ и третьего мира. При учете России и стран СНГ эта цифра возрастет до 35 тысяч тонн в год. Существующие сегодня мощности по производству поликристаллического кремния не в состоянии выполнить эти требования. Если учитывать будущие требования рынка кремния для солнечной энергетики, то эти цифры возрастут до значения в 60 тысяч тонн в год к 2000 году и до 90 тысяч тонн в год к 2003 году. [1]
Способы получения кремния
Способы получения кремния чистотой > 99,0 масс % можно разделить на три основные группы: металлургический, электрохимический и химический [2].
В первом случае кремний получают восстановлением расплава SiO2 углеродом в электродуговых печах при температурах 1500-1800 оС. Процесс восстановления описывается уравнением: SiO2 + 2C = Si + 2CO. Получаемый технический кремний в соответствии с требованиями ГОСТ 2169 и ТУ 42-5-220 имеет марки: КРП, КРОО, КРО, КР1, КР3, КР2, в которых содержание кремния изменяется от 96,0 до 99,0% соответственно, а основными примесями являются Fe, Al, Ca. Выход достигает 80-85%.
Сравнительно небольшое количество кремния получают электрохимическим методом, в частности электролизом в расплавах LiF, KF, SiF4 или Na2SiF6, K2SiF6 [2]. В качестве анода применяются кремнемедные сплавы, а катоды изготавливают из Si. Содержание примесей в кремнии не превышает 10-4 масс.%.
В основе получения Si цинкотермическим восстановлением кремнийсодержащих соединений лежит реакция, предложеная Н.Н. Бекетовым: SiCl4(газ) + 2Zn = Si(тв) + 2ZnCl2(газ). Кремний получают в виде пленок и игольчатых кристаллов различной крупности. Этот метод в промышленности используется в СССР и фирмой "Дьюпон де Немур".
В лабораторных условиях опробовались способы получения кремния на основе реакций:
SiCl4 + Na = Si + 4NaCl
SiF4 + Na = Si + 4NaF
Выход по Si в этом случае достигал 96%.
В связи с возрастающей потребностью кремния для солнечных батарей появляется перспективность вновь использовать данный метод в промышленных масштабах.
К третьей группе относятся методы получения кремния, в которых технический кремний переводится в соединение (галогениды, силаны, и др.), позволяющее провести глубокую очистку, например, ректификацией, из которых затем получают высокочистый кремний.
Один из первых таких методов, нашедших сравнительно небольшое промышленное применение является йодидный метод, в основе которого лежит смещение равновесия реакции Si + 2I2 ó SiI4 вправо при изменении температур от 700 – 850оС (в низкотемпературной зоне реактора или отдельного реактора) и влево при температурах 1100 – 1200 оС (в высокотемпературной зоне). В ряде технологических схем предусмотрена очистка SiI4 перед разложением.
Рассмотрим два варианта метода. В первом используют ячейку, в которой совмещены синтез и разложение SiI4. В ячейку помещают исходный кремний и вводят некоторое количество йода. Ячейку нагревают до 700 – 850 оС. При этом кремний реагирует с йодом с образованием SiI4. Последний соприкасаясь с нитью, нагретой до 1100 – 1200 оС, разлагается с осаждением на ней кремния.
По второму варианту синтез и разложение тетройодида кремния осуществляют отдельно, а промежуточный продукт тетройодид кремния очищается от примесей в дистилляционной колонне.
Синтез тетройодида кремния может быть осуществлен в реакторе с кипящим слоем. Основой конструкции реактора является кварцевая труба, установленная вертикально в печи. Йод испаряется в стальном бойлере, обогреваемом до 330 оС горячим маслом. Образовавшийся SiI4 поступает в конденсатор-испаритель, а затем в кварцевую ректификационную вакуумную колонну. Очищенным SiI4 собирают в кварцевый сборник, помещаемый в испаритель. Испаренный SiI4 направляют в аппарат разложения, состоящий из вертикальной кварцевой трубки, установленной на верхней части сборника SiI4. Внутри трубки крепится кремниевый пруток, нагреваемый до 1100 оС токами высокой частоты. Выходящие от аппарата непрореагировавший SiI4 и продукт реакции йод конденсируются в вакуумном конденсаторе.
Помимо возможности получения кремния высокой чистоты, йодидный метод обладает еще одним важным достоинством – сравнительно высокой безопасностью. Однако высокая стоимость йода и сложность аппаратурного оформления сдерживает его широкое распространение.
Имеются также публикации о получении в опытно-промышленном масштабе кремния термическим разложением трибромсилана. Однако перспектива метода на сегодня остается неясной. В настоящее время основными химико-технологическими системами (ХТС), применяемыми всеми ведущими производителями кремния в мире являются производства, использующие трихлорсилан (78-90% всего производства кремния) и моносилан (18-20%).
Разработки технологий на основе моносилана начались в 70-х годах [1], когда повысился спрос на сверхчистый кремний для ИК-детекторов, и были реализованы после 1985 года фирмами Union Carbide и Komatsu Electronic Metals, Advanced Silicon Materials, MEMC Pasadena.
Химико-технологические системы с использованием силана (SiH4) имеют основные отличия в способах получения силана. Рассмотрим несколько примеров.
Получение поликристаллического полупроводникового кремния пиролизом SiH4. Процесс состоит из следующих основных стадий:
- получение силицида магния (Mg2Si), например, сплавлением технических кремния и магния (содержание основных веществ не менее 98%) в атмосфере водорода при 550 – 600оС:
H2
2Mg + Si = Mg2Si;
- разложение силицида магния хлоридом аммония при –40 оС в
среде жидкого аммиака:
NH3(ж)
Mg2Si + NH4Cl = SiH4 + 2MgCl2 + 4NH3;
-очистка моносилана кремния ректификацией (остаточное
содержание примесей 10-7 – 10-8%);
-термическое разложение (пиролиз) моносилана при 850-1000 оС:
![]() SiH4
Si + 2 H2.
SiH4
Si + 2 H2.
Необходимо отметить, что получаемый при пиролизе водород обладает высокой степенью чистоты и используется на первой стадии химико-технологического процесса или сопутствующих производствах.
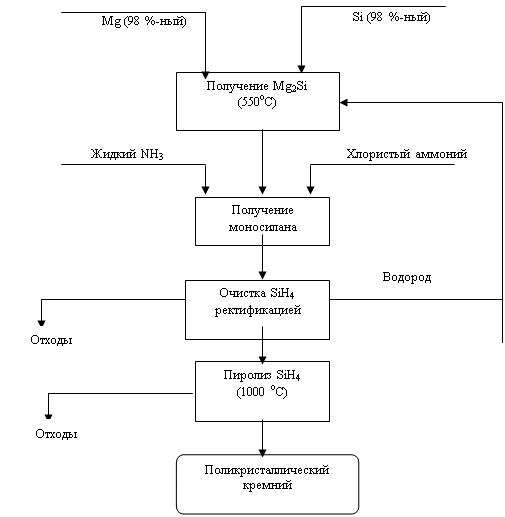 |
Функциональная схема такого производства поликристаллического полупроводникового кремния приведена на рис.2.
Рис.2 Функциональная схема производства поликристаллического полупрводникового кремния пиролизом моносилана.
В схеме, показанной на рис.2 сырьем служат технический кремний, тетрахлорсилан(SiCl4) и водород. На первом этапе получают трихлорсилан(SiHCl3) по реакциям:
Si(техн) + SiCl4 + 2Н2 = 4SiHCl3,
H2 + SiCl4 = SiHCl3 + HCl.
Непрореагировавший SiCl4 после очистки возвращают в реактор синтеза SiHCl3.
Из трихлорсилана получают дихлорсилан:
4SiHCl3 = 2SiH2Cl2 + 2SiCl4,
а затем и моносилан:
2SiH2Cl2 = SiCl4 + SiH4.
Полученный на этих этапах SiCl4 выделяют, очищают и вновь используют.
Силан после предварительной очисткой или без нее подвергают термическому разложению.
Моносилан может быть получен в результате комплексного использования сырья при производстве суперфосфатных удобрений [1]. Так, при обработке фторида кальция (CaF2), содержащегося в сырье вместе с оксидом кремния, серной кислотой происходит образование тетрафторсилана (SiF4) через фторкремниевую кислоту (H2SiF6) по реакции:
H2SiF6 = SiF4 + 2HF.
Далее процесс получения моносилана протекает по реакции:
SiF4 + NaAlH4 = SiH4 + NaAlF4.
Моносилан подвергается комплексной очистке, включающей конденсацию, ректификацию. В данной схеме использован вариант гомогенного разложения очищенного моносилана с получением гранулированного кремния.
 |
Рис.2 Функциональная схема производства поликристаллического полупрводникового кремния пиролизом моносилана
Особенности процесса термического разложения силана
Силан начинает разлагаться на кремний и водород при ~ 653К. температурная зависимость степени разложения силана приведена на рис. из которго видно, что в интервале 653-723К разложение силана незначительно. В промежутке между 723 и 773К степень разложения растет и уже при 773К достигает ~75%. В дальнейшем с ростом температуры степень разложения снова постепенно увеличивается и при 973К достигает ~100%.
Начальной стадией процесса является гомогенная реакция с образованием силана:
SiH4 ®SiH2 + H2
Далее на активном участке (*) поверхности кремниевой подложки происходит адсорбция силана:
SiH2 +(*) ®SiH2 (адс)
После чего образуется вторая связь Si-Si (кристаллизация кремния) и происходит десорбция водорода:
SiH2 (адс) ®Siтв+ H2 + (*)
При этом образуется активный участок (*) поверхности и процесс осаждения по приведенному механизму возобновляется.
Энергия активации, как полагают, состоит из ряда слагаемых: - газофазная реакция
SiH4 ®SiH2 + H2, DН = 217,88 кДж/моль
- адсорбция SiH2 на поверхности кремния
SiH2(г) +(*) ® SiH2(адс), Н = - 215,79 кДж/моль
- образование второй связи
Si-Si, H=-215,79 кДж/моль
- десорбция 2Н из связей Si-H
H=2Hx кДж/моль
Экспериментальная Н=146,65кДж/моль
Отсюда следует энергия активации для десорбции водорода, Нх = 180,17кДж/моль, что находится в хорошем соответствии с экспериментальными значениями (167,6-192,7 кДж/моль).
Анализ температурной зависимости скорости осаждения кремния из силана показывает, что при высоких температурах (1273К) скорость роста кремния определяется процессом переноса силана к поверхности, при более низких температурах (~ 773-1123К) - скоростью химической реакции.
Экспериментальная зависимость скорости осаждения кремния от температуры, полученная для одного из типов промышленных реакторов, показана на рис. . Снижение скорости осаждения кремния с ростом температуры связано с увеличением числа гомогенных реакций и образованием порошка полисиланов. Таким образом процесс образования полисиланов играет существенную роль в кристаллизации стержней, и его следует учитывать при разработке программ осаждения и конструкции реакторов.
Расход силана в течении процесса меняют по специальной программе, которая учитывает повышение температуры в объеме ректора с ростом диаметра стержней и увеличения поверхности осаждения. Наряду с обеспечением приемлемой скорости осаждения кремния задача программного расхода силана состоит в том, чтобы избежать образование порошка полисиланов в объеме реактора. Одна из программ приведена на рис. .
Для уменьшения вероятности образования порошка полисиланов предлагается наряду с силаном в реактор подавать галогенсиланы (SiH3Cl, SiH2Cl2, SiHCl3, SiCl4) в количестве 0,1-20,0%.
Однако такой технологический прием требует весьма высокой чистоты галогенсиланов, которая не должна уступать чистоте силана.
Аппаратурное оформление процесса разложения силана
Термическое разложение силана осуществляют, как правило, при избыточном давлении в металлических водоохлаждаемых реакторах. Конструкция реакторов в целом близка к используемой для производства кремниевых стержней водородным восстановлением хлорсиланов, хотя и имеет ряд отличительных элементов. Например, в одном из реакторов подача силана в реакционный объем производится снизу, а вывод абгазов сверху реактора. Верхняя крышка реактора имеет коническую форму и съемная.
Главное достоинство этой конструкции – то, что уменьшает вероятность попадания порошка полисиланов в растущие кремниевые стержни.
Более сложный реактор термического разложения силана(рис) состоит из съемной металлической камеры 9 и основания (поддона) 17. Металлическая камера 9, полая внутри, снабжена входным 5 и выходным 7 патрубками для охлаждающей жидкости. В верху камера снабжена патрубком 8 для вывода газа, образующегося в результате термического разложения. Для наблюдения за процессом осаждения камера снабжена иллюминаторами 12, которые позволяют контролировать верхнюю, нижнюю и среднюю части кремниевых стержней 6. Основание 17 также охлаждается потоком хладагента, который подается и выводится через соответствующие патрубки 18 и 19.
ИНТЕРЕСНОЕ
© 2009 Все права защищены. |